11 月 14 日消息,據韓媒 ETNews 報道,三星電子、SK 海力士、美光均對在下代 HBM4 內存中采用無助焊劑鍵合(Fluxless Bonding)技術抱有興趣,正在進行技術準備。
SK 海力士此前已宣布了 16 層堆疊 HBM3E,而從整體來看 HBM 內存將于 HBM4 開始正式轉向 16 層堆疊。由于無凸塊的混合鍵合技術尚不成熟,傳統有凸塊方案預計仍將是 HBM4 16Hi 的主流鍵合技術。
更多的 DRAM Die 層數意味著 HBM4 16Hi 需要進一步地壓縮層間間隙,以保證整體堆棧高度維持在 775 μm(IT之家注:即 0.775 mm)的限制內。
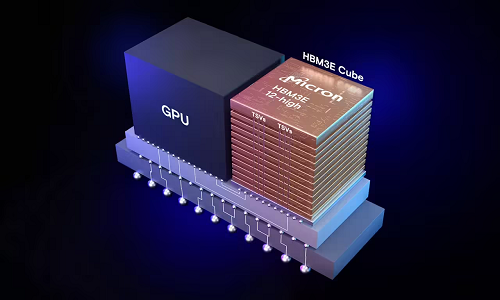
在這一背景下,三大內存原廠均注意到了現有 HBM 鍵合工藝使用的助焊劑:助焊劑可清理 DRAM Die 表面的氧化層,保證鍵合過程中機械和電氣連接不會受到氧化層影響;但助焊劑的殘余也會擴大各 Die 之間的間隙,提升整體堆棧高度。
消息人士表示,三大 HBM 內存原廠對無助焊劑鍵合的準備程度不同:美光在與合作伙伴測試工藝方面最為積極、SK 海力士考慮導入、三星電子也對此密切關注。

本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:aet@chinaaet.com。

