中國科學院上海微系統與信息技術研究所研究員歐欣課題組和西安電子科技大學郝躍課題組教授韓根全合作,在氧化鎵功率器件領域取得新進展。該研究成果于12月10日在第65屆國際微電子器件頂級會議——國際電子器件大會(International Electron Devices Meeting, IEDM)以口頭報告形式正式發布:First Demonstration of Waferscale Heterogeneous Integration of Ga2O3 MOSFETs on SiC and Si Substrates by Ion-Cutting Process。這是我國(包括港、澳、臺)在IEDM會議上發表的首篇超寬禁帶半導體領域的論文,說明我國也成為氧化鎵研究領域的重要創新國家之一。
氧化鎵作為第三代寬帶隙半導體材料,具有禁帶寬度更大、擊穿場強更高的優勢。Ga2O3 是帶隙最大的寬禁帶半導體材料之一,對于大功率、高頻裝備,氧化鎵具有重大的戰略意義和經濟價值。它的Baliga優值分別是GaN和SiC的四倍和十倍,為未來功率器件的發展提供了更廣闊的視野。根據日本權威經濟研究機構Fuji KeiZai公司的市場預測,到2025年,氧化鎵在整個第三代半導體材料的市場份額為27%。然而由于氧化鎵極低的熱導率,散熱能力成為氧化鎵功率器件應用的最大瓶頸。歐欣課題組和韓根全課題組利用“萬能離子刀”智能剝離與轉移技術,首次將晶圓級β-Ga2O3單晶薄膜(< 400 nm)與高導熱的Si和4H-SiC襯底晶圓級集成,并制備出高性能器件。高質量的氧化鎵薄膜的厚度不均勻性為±1.8%,通過化學機械拋光優化后薄膜的表面粗糙度達到0.4nm以下。器件電學測試表明在300K到500K的升溫過程中開態電流和關態電流沒有明顯退化,對比基于同質氧化鎵襯底的器件,熱穩定性有顯著的提升,SiC基氧化鎵MOSFET器件即使在溫度500K時,擊穿電壓依然可以超過600V。
氧化鎵無疑是超寬禁帶半導體材料的典型代表,禁帶寬度可以接近5eV,在金剛石材料摻雜技術遲遲不能突破的今天,該工作在超寬禁帶材料與功率器件領域具有里程碑式的重要意義。首先,異質集成為Ga2O3晶圓散熱問題提供了最優解決方案,勢必推動高性能Ga2O3器件研究的發展;其次,該研究將為我國Ga2O3基礎研究和工程化提供優質的高導熱襯底材料,推動Ga2O3在高功率器件領域的規模化應用。

晶圓級異質集成氧化鎵薄膜制備
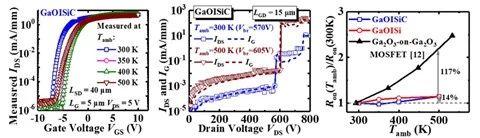
高性能碳化硅/硅基氧化鎵薄膜器件性能

