日前,科技創新情報SaaS服務商智慧芽(PatSnap)挑選了中國大陸半導體封測領域TOP10企業為研究對象,從專利維度對10家企業的創新能力、企業全球化布局、被同行關注度、半導體封測領域關鍵技術鏈完整度等信息進行了統計分析。
與此同時,第十九屆中國半導體封裝測試技術與市場年會(CSPT 2021)也剛剛在江陰落下帷幕,中國半導體協會封裝分會當值理事長,長電科技董事兼首席執行長鄭力發布了《中國半導體封測產業現狀與展望報告》。
我們引用并綜合了兩份報告中的核心內容,希望能夠借此比較完整的勾勒出中國大陸封測產業的全貌,有助于讀者加深對中國封測產業現狀的認知與理解。
TOP10企業專利排行榜解讀
一、龍頭企業創新優勢明顯
從截止2022年1月14日公開的專利數據來看,專利申請量超過1000件的企業共有4家。專利申請量最高的企業為長電科技,以4660件專利申請位居首位,為封測領域中國大陸創新龍頭;第二名為天水華天科技,申請量為1062件;華潤微電子封裝測試事業群和通富微電子分列第三和第四位,蘇州晶方半導體以513件的專利申請量,位于榜單中間位置。

圖1:中國大陸半導體封測領域TOP10企業專利量排行榜
整體看來,除個別年份之外,長電科技專利年申請量均居于首位,尤其在早期,其專利申請量具有明顯的優勢。2014年之后,天水華天科技、華潤微電子封裝測試事業群、通富微電子和蘇州晶方半導體逐漸縮小了與龍頭企業的競爭力差距。

圖2:中國大陸封測領域頭部企業專利申請趨勢
圖3、圖4從數量和維持年限長短兩個維度分析了企業的有效專利情況。從數量來看,大部分申請人的有效專利超過總量一半,其中,長電科技有效專利數量最高,超過3000件;通富微電子有效專利數量排名第二;華潤微電子封裝測試事業群、天水華天科技有效專利數量分別位居第三和第四位。

圖3:中國大陸半導體封測領域TOP10企業有效專利統計
大部分企業有效專利維持年限主要集中在5-10年之間。其中,長電科技、通富微電子、天水華天科技、華潤微電子封裝測試事業群和蘇州晶方半導體維持年限在大于10年和5-10年間的專利占比突出;氣派科技和甬矽電子有效專利維持年限在1-3年的較為突出,表明其專利技術相對較新。

圖4:中國大陸半導體封測領域TOP10企業有效專利維持年限分布
二、 頭部企業重視拓展中國大陸以外市場
專利不同區域申請情況可以側面反映企業全球化市場布局情況。長電科技在大陸以外布局專利最多,范圍也最廣泛,布局區域依次包括:美國、新加坡、中國臺灣、韓國、日本、德國和歐洲;蘇州晶方半導體其次,比較關注在美國、中國臺灣以及韓國的專利保護;天水華天科技、通富微電子、氣派科技、華潤微電子封裝測試事業群分列3-6位。甬矽電子、欣中封測、太極半導體和沛頓科技在大陸以外專利布局相對較少。

圖5:中國大陸半導體封測領域TOP10企業中國大陸以外專利布局統計
三、頭部企業被同行關注度高
專利被引次數分析,通常用于反映企業被同行關注度。長電科技、天水華天科技、通富微電子、華潤微電子封裝測試事業群和蘇州晶方半導體有部分專利被引頻次在10次以上,說明這些企業被同行關注度較高。長電科技還有部分專利被高頻引用(被引頻次在30次以上),進一步表明其被同行關注度最高。

圖6:中國大陸半導體封測領域TOP10企業專利被引頻次分析
四、頭部企業技術完整度較高
10家企業中,長電科技專利布局涵蓋所有封測領域關鍵技術,在封裝引線框架、制造或處理半導體、按配置特點進行分區分封裝等分支(H01L23/495、H01L21/00、H01L23/31)上具備優勢;天水華天科技和通富微電子關鍵技術鏈完整度基本并列第二位,其中通富微電子稍側重在引線或其他導電構件的連接和器件密封(H01L21/60、H01L21/56)方向的專利布局,而天水華天科技側重封裝引線框架(H01L23/495)方向。
蘇州晶方半導體次于上述三者排名第三,其專利布局重點在于圖像結構(H01L27/146);華潤微電子封裝測試事業群和氣派科技關鍵技術鏈完整度分別排名第四、第五位,兩者專利和技術儲備均以封裝引線框架(H01L23/495)為主;甬矽電子則以按配置特點進行區分封裝(H01L23/31)為其主要研發方向。
除上述封測領域關鍵技術類別,其它技術,如微觀結構系統(B81B7/00)、類似線狀的焊接或黏結結構(H01L23/49)、冷卻裝置、加熱裝置、通風裝置或溫度補償裝置(H01L23/34)、在器件內部從一個組件向另一個組件通電的裝置(H01L23/52)、支承或夾緊結構(H01L21/683)等技術類別也得到了關注。

圖7:中國大陸半導體封測領域TOP10企業封測技術鏈完整度分析
先進封裝成為全球封裝市場主要增量
“先進封裝,或者說芯片成品制造,可能成為后摩爾時代的重要顛覆性技術之一,特別是后道成本制造在產業鏈中的地位愈發重要,有望成為集成電路產業新的制高點。”鄭力在發表主題演講時如是說。
近年來,隨著智能手機、物聯網、人工智能、汽車電子等新興領域應用市場的快速發展,帶動了全球封裝測試產業的持續增長。Yole數據顯示,2020年全球封裝市場規模微漲0.3%,達到677億美元。該機構同時也在《Status of the Advanced Packaging Industry 2021》中預測,2021年先進封裝的市場規模約為350億美元,先進封裝占全部封裝的比例約為45%。按此推算,2021年全球封裝市場規模約上漲14.8%,約達777億美元。

全球封裝市場規模(2014-2021) 資料來源:Yole
未來,全球半導體封裝測試市場將在傳統工藝保持較大比重的同時,繼續向著小型化、集成化、低功耗方向發展,在新興市場和半導體技術的發展帶動下,附加值更高的先進封裝將得到越來越多的應用,封裝測試市場有望持續增加。
Yole預測,2021年先進封裝的全球市場規模約350億美元,到2025年將增長至420億美元,先進封裝在全部封裝的占比將從2021年的45%增長到2025年的49.4%。2019-2025年,全球先進封裝市場的CAGR約為8%,相比同期整體封裝市場(CAGR=5%)和傳統封裝市場,先進封裝市場的增長更為顯著,將成為全球封裝市場的主要增量。

全球半導體封裝測試產業結構(2016-2025年) 資料來源:Yole
鄭力表示,相比較于芯片制造和芯片封測產業,中國半導體產業此前更注重芯片設計行業,這一現象目前正在逐步扭轉。根據中國半導體行業協會統計數據顯示,2021年中國集成電路產業銷售額為10458.3億元。其中,設計業銷售額為4519億元,制造業銷售額為3176.3億元,封測業銷售額2763億元,占比為43.2%:30.4%:26.4%。依據世界集成電路產業三業結構合理占比(設計:晶圓:封測)的3:4:3,中國集成電路的封裝測試業的比例尚處于IC制造業比較理想的位置。
2020年-2021年,受益于全國新冠肺炎疫情控制較好,各行業復工復產較早,遠程辦公、在線教育、家庭娛樂等需求的規模化興起,智能駕駛、醫療、數據中心、5G及loT的快速滲透深化,中國封測產業再次實現了快速增長。中國半導體行業協會統計,2020年中國封測業產值達到2509.5億元,同比增長6.8%,2021年中國封測產業規模為2763億元,同比增長10.1%。
從分布區域來看,目前國內封裝測試業分布區域主要集中于長江三角洲地區。江蘇、上海、浙江三地2020年封測業銷售額合計達到1838.3億元,占到2020年我國封測業銷售額的73.3%。根據江蘇省半導體行業協會統計,截至2020年底,中國半導體封測企業有492家,其中2020年新進入半導體封測(含投產/在建/簽約)的企業共71家。江蘇封測企業數量最多,共有128家,其次是廣東97家、山東48家、安徽40家、上海38家、浙江34家。截至目前,2021年數據尚未發布,但全國封測產業整體分布態勢保持不變。
鄭力將中國封測產業面臨的發展機遇分為政策、市場和技術三部分。在政策機遇方面,從2016年到2020年,相關部門都在發布新的集成電路產業政策,面向封測和相關的裝備、材料業政策也非常之多,對于封測產業有了非常大力度的支持。
在市場機遇方面,2021年中國集成電路進口量為6354.8億塊,同比增長16.9%,2013-2021年GAGR為11.3%;2021年中國集成電路進口用金額為4325.5億美元,同比增長23.6%,2013-2021年GAGR為9.4%。這反映出國內市場自我供給不足的狀況還是沒有根本改變,國內市場所需的高端集成電路產品,如通用處理器、存儲器等關鍵核心產品仍然依賴進口,再加之貿易摩擦的風險和國外禁運,因此,中國封裝產業的本土化發展潛力巨大。
在技術機遇方面,由于摩爾定律發展至今已遇到瓶頸,芯片特征尺寸已接近物理極限,先進封裝技術成為延續摩爾定律的重要途徑,封測企業迎來良機。未來,“顛覆性”技術創新將成為驅動半導體技術向前發展的關鍵,先進封測技術成為行業的熱點,未來的10-20年,異構集成技術賽道將換擋提速。
當然,在中國封測產業的快速發展中,同樣也存在著許多挑戰,以下六方面被重點提及,分別是:
●關鍵設備依賴進口,設備交付周期長,影響擴充產能。
●客戶會指定主要原材料,造成主材料更換比較困難,而高端的產品封裝都被海外壟斷。
●產品開發需要客戶來進行驗證,但驗證周期長。
●部分原材料國產純度無法滿足(如高精度銅合金帶),但進口材料周期長、甚至有不被接單的風險。
●材料成本上升,不利于企業進一步做大做強。
●研發、工藝人才缺口大。
為此,鄭力提出四點建議:更加關注芯片成品制造環節、支持產業鏈協同創新、加大扶持封測企業、以及關注人才的吸引和培養,以更好地推動中國半導體封測產業的整體進步。
未來高算力芯片發展三路徑
中國工程院院士、浙江大學微納電子學院院長吳漢明在演講中指出,后摩爾時代的到來,導致前端制造面臨三個級別的挑戰:以精密圖形為代表的基礎挑戰、以新材料為代表的核心挑戰和以良率提升為代表的終極挑戰。

吳漢明指出,摩爾定律發展已經開始放緩,晶體管密度不能按照以往兩年增加一倍的節奏發展。從制造成本上來看,28納米成為了“分水嶺”,28nm以前的工藝制造成本下降速度較快,但28nm之后制造成本下降趨緩;性能方面,2002年以前每年可以提升52%,到2014年,每年提升降為12%,而到了2018年,性能每年僅能提升3.5%,所以與成本類似,性能提升也呈趨緩態勢。


為此,他提出了三條可以突破高算力發展瓶頸的創新途徑:三維異質集成晶圓級集成、存算一體范式、可重構計算架構。如下圖所示,采用28納米工藝的全球最大容量存算一體芯片,單芯片算力達到了300-500TOPS;采用40納米工藝,可實現能效全球領先的混合粒度可重構芯片。據此,吳漢明建議,我們可以考慮在1-2年內,將存算一體芯片和可重構計算芯片利用三維集成技術集成在同一基底上,隨后在3-4年內,再通過晶圓級集成在晶圓硅片上。
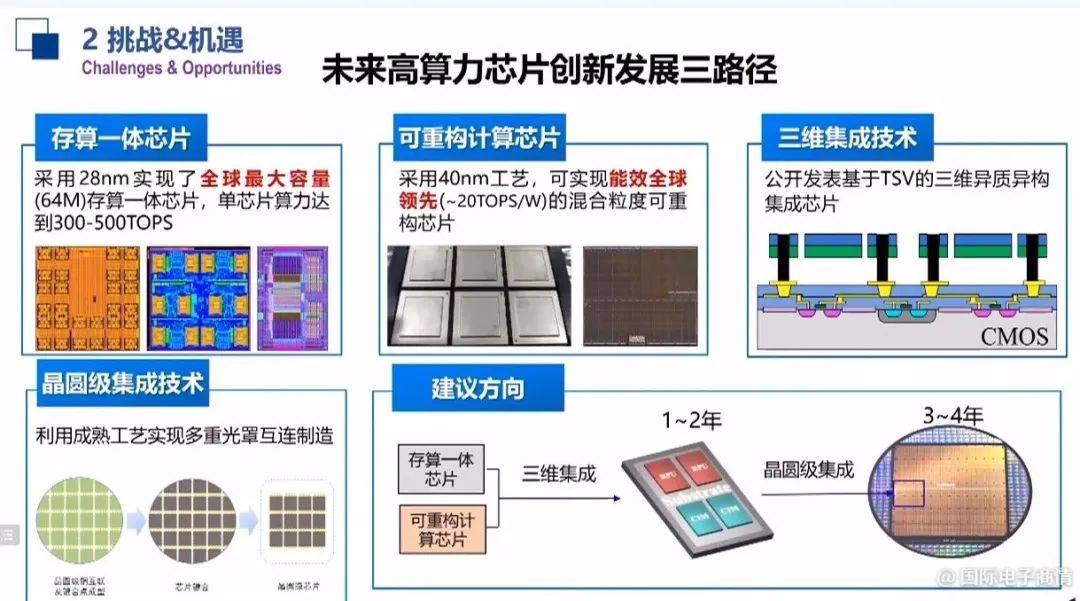
作為教育界代表,在談到集成電路產教融合話題時,吳漢明將三維器件(FinFET)、高介電常數和金屬柵(HKMG)、應變硅(Strained Si)和源漏提升(Raised S/D)列為本世紀集成電路器件的四大產教融合成果轉化,并同時指出,我國目前真正通過產教融合轉化出來的還很少,核心問題在于國內缺少能夠使交叉學科可以開花結果,真正實現產業化的Pilot-line(先導線)。

而芯片制造技術成果轉化的特點,一是轉讓,將技術成熟、可以在生產上直接應用的成果,在其使用范圍內加以應用和推廣,擴大生產規模;二是轉化,將實驗室取得的初試成果進行研究開發和中間試驗,使之變成生產上可以直接采用的成熟技術,實現大生產。就芯片制造成果轉化而言,核心是演示生產可行性,也就是中試環節驗證,也可以認為:缺少中試的技術轉化難以生產化。
結語
中國半導體行業協會集成電路設計分會理事長、清華大學教授魏少軍指出,雖然封測業看似仍以加工為主要特點,而且一度被認為技術含量不高,但未來,以三維混合鍵合技術為代表的微納系統集成有可能改變整個產業格局,前道后道工序相結合,甚至在前道工藝當中嵌入后道,后道當中集成前道,將成為一種大的趨勢,這給封測業、設計業、制造業提出了全新的挑戰。所以,真正的未來可能是在封測業,封測業本身的技術進步至關重要,對整個半導體行業具有非常重要的引領作用。
更多信息可以來這里獲取==>>電子技術應用-AET<<


